[技術報告] 關於PFA管材表面粗糙度之新提案
2020.08.25
關於PFA管材表面粗糙度之新提案
(可用於微型化半導體晶片的超平滑PFA管材)
〇引言
PFA(四氟乙烯-全氟烷基乙烯基醚共聚物)是一種可熔融成型的全氟樹脂1)。它的分子量數為十萬,熔融粘度為0.01至0.1 MPa·s(380°C),可適用於壓縮成型,押出成型,射出成型等各種製品,並於市面上銷售。隨著半導體工廠中,藥劑用管材、配件、閥門,水泵,filter housing、wafer carriers等各種組件的使用、高純度、耐藥性極佳PFA的需求也在不斷擴大2)。
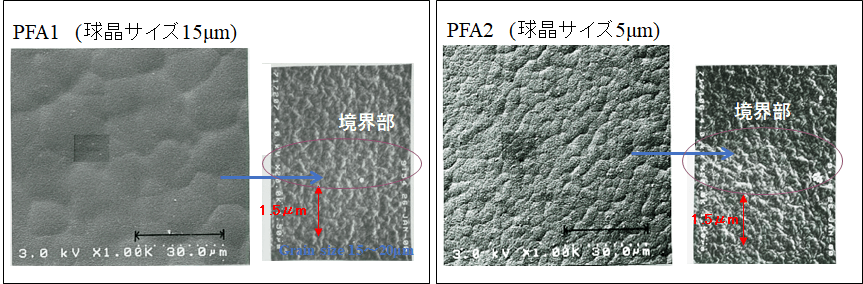
コメント:境界部に溝はなく、球晶表面と同等の表面状態が認められる。
〇氟樹脂材料
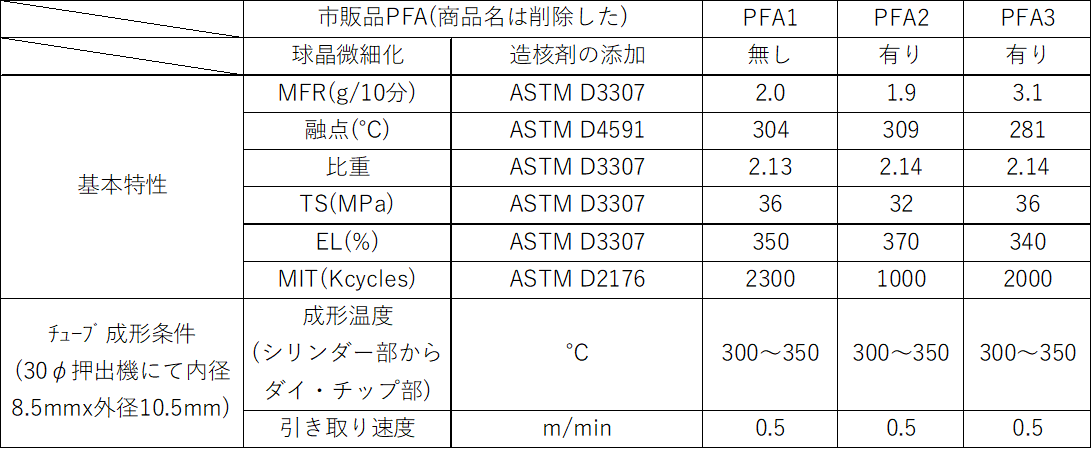
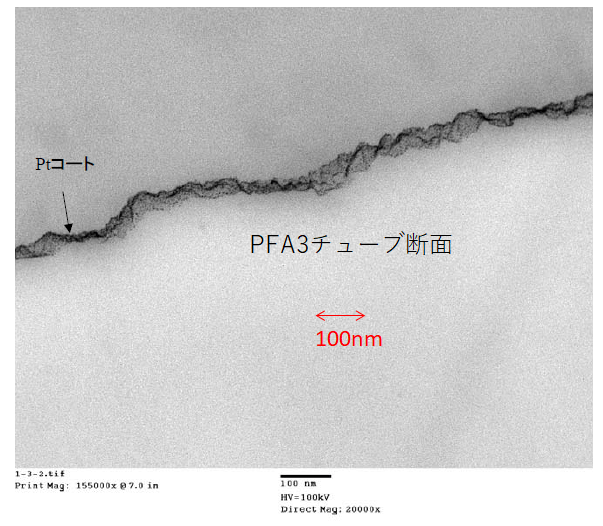
(3) 透過原子力顯微鏡(AFM)測量
關於奈米尺寸的污染微粒子,必須要將球晶表面的奈米尺寸之表面粗糙度視為問題。透過AFM依照以下條件測量了PFA管表面粗糙度,以及將本次測試長度調整為比球晶尺寸小的3μm角領域後的表面粗糙度。透過原子力顯微鏡(AFM)測量的表面粗糙度Ra乃使用掃描探針顯微鏡(AFM5200S(HITACHI High-Tech社製),以Dynamic Force Mode、測試料表面的測量面積3μm角、掃描速度1Hz,x-y方向256×256分割、懸臂SI-DF-20(Si, f=134kHz,C=16N/m)的條件下測出的AFM近红外光譜儀照像圖,是透過傾斜自動校正處理算出的。將AFM觀察的領域設定為3μm角,粗糙曲線的橫軸為29882nm,縱軸為250nm所顯示結果為圖4。其次,將AFM觀察的領域設定為3μm角,粗糙曲線的橫軸為2988nm,縱軸為39nmn其顯示結果為圖5。圖4突起部分的波型表示為一個球晶。縱橫向的比例與實際不同,圖4的縱向倍率約放大了20倍,因此成像看起來比實際的凹凸誇張明顯。另一方面,如文獻(2)記載的射出成型品會大大受模具表面的表面粗糙度影響(依存?),與模具的接觸面不會出現球晶造成的六角型。另外,因機械加工所切削的表面也不會出現球晶表面。這些種種比壓出成型的管內面之表面粗糙度還粗,SEMI規格(F57-0301)所記載的,相較於PFA內側表面的表面粗糙度Ra≦0.25μm,射出成型品是Ra≦0.38μm、機械加工品則是Ra≦0.62μm。這些情況下也有因為傷痕的影響導致表面粗糙度變大的狀況。但是管狀的話,如同前述記載,可了解並非依照球晶尺寸來測量表面粗糙度,而必須要測量球晶表面的粗糙度。
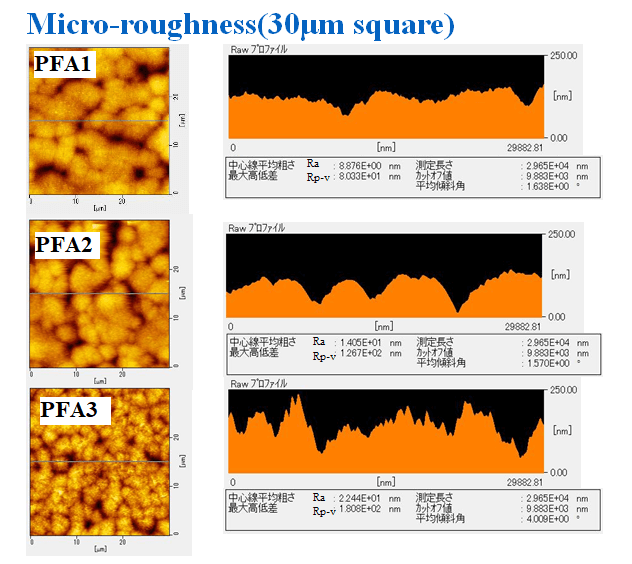
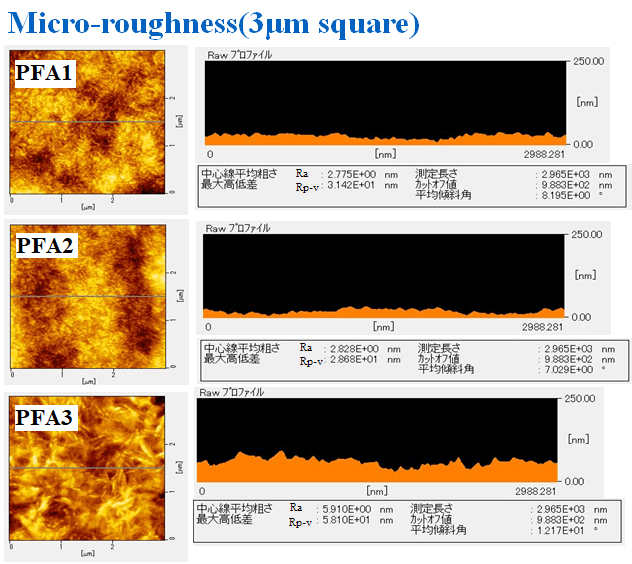
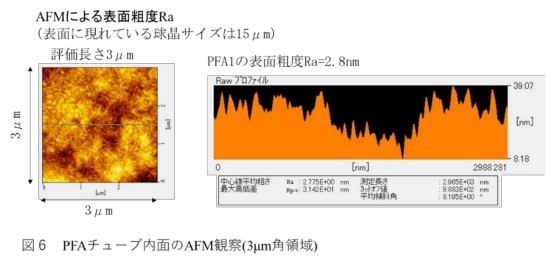
(4)PFA材料與各種表面粗糙度測定方法之比較
將PFA1,PFA2,PFA3的原料成型的PFA管,來比較AFM測定的球晶表面的表面粗糙度Ra。將其測定結果以圖4、圖5、圖6來表示。各種測定領域,換句話說就是改變測量長度來測量表面粗糙度,將其結果整理成表2。
表2 PFAチューブの表面粗度測定結果のまとめ

測量長度為3μm的情況下,得到PFA1,PFA2 Ra=2.8(nm)的結果。
PFA3的結果為Ra=5.9(nm)。
注) 表(1)中的Ra為,從粗糙度曲線上去除基準長度的部分,並將該部分的平均線到測量曲線的偏差絕對值,相加後平均出來的值,就是表面粗度(表面粗糙度)。
(2) Rp-v(在記載上也有被稱為Ry)是從粗糙度曲線上去除基準長度的部分,並將該部分的平均線到最高峰Yp和到最谷底Yv的總和,即為Rp-v = Yp + Yv。
在傳統的表面粗度中,球晶的邊界存在著凹槽,可以想像的出,那個凹凸的大小被大小為20~60nm的異物附著在上面的樣子。但是,實際按比例繪製圖形時,可以發現如圖7所示,與實際的情況有很大的差距。
図7 球晶サイズ基準と球晶表面の表面粗度
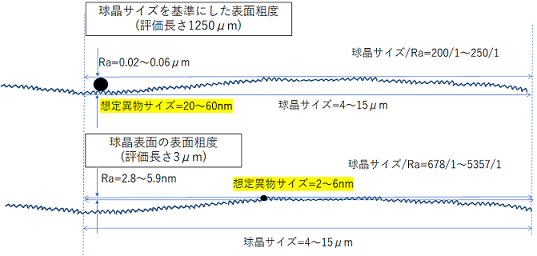
這次所提案的球晶表面的表面粗度,異物尺寸為2~6nm。可以輕易的想像出,它附著在凹凸上合適的樣子。是符合實際情況的測試方式。
(5)奈米尺寸的表面粗度分析
形成在球晶表面上的凹凸,是由該分子鏈的折疊結構,許多束的層狀晶體所組成的層狀晶束所形成。奈米尺寸凹凸(平滑性)的大小,是由層狀晶束的大小所決定。 PFA是TFE和PAVE的共聚物,但是根據PAVE的類型和成核劑的數量,層狀晶束的大小可能會有所不同,奈米的光滑度也會出現差異。如下圖8所示,球晶表面的SEM觀察,是用エリオにクス社所製造的ERA-9000在進行。
図8 PFAチューブの球晶表面のSEM(3万倍)観察
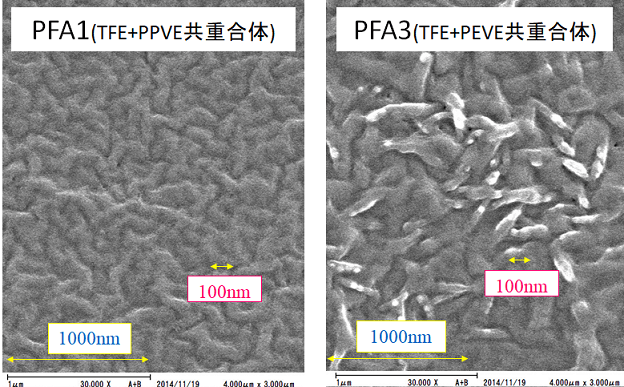

結果如圖8所示,算數平均粗度的Ra是平均值。但在同一裝置,電線三次元粗糙度分析上,長度1μm中的測試中,測量了其深度和數量的結果如圖9所示。透過這次的提案,由3μm角上的AFM來測量球晶表面的表面粗度的方式。
說不定在在下個半導體芯片的時代中,被視為問題的微粒子異物問題能透過表面粗度來對應,將被熱烈討論一番呢。
最後
隨著球晶的微細化,很明顯的關於目前平滑度的討論與實際情況的是相差甚遠的。
透過SEM的觀測上可以很明顯的得知,在球晶邊界上沒有深的溝槽,而是與球晶表面的表面結構是相同的。 換句話說,奈米等級上球晶表面的表面粗度所指的是,管材內全體表面的表面粗度。
在本文中,我們以PFA管材的表面粗度作為測量,透過AFM來測量球晶表面的表面粗度的方式,來對應半導體芯片的微細化。 但是,即使是最新的粒子測量器,也僅限於測量在尺寸20~30 nm之間。
期待未來在奈米表面粗度以及奈米粒子的污染和清潔關係上,能有進一步的探討。
(可用於微型化半導體晶片的超平滑PFA管材)
DAIKIN工業 今村 均
〇引言
PFA(四氟乙烯-全氟烷基乙烯基醚共聚物)是一種可熔融成型的全氟樹脂1)。它的分子量數為十萬,熔融粘度為0.01至0.1 MPa·s(380°C),可適用於壓縮成型,押出成型,射出成型等各種製品,並於市面上銷售。隨著半導體工廠中,藥劑用管材、配件、閥門,水泵,filter housing、wafer carriers等各種組件的使用、高純度、耐藥性極佳PFA的需求也在不斷擴大2)。
〇有關PFA管材表面粗糙度
高純度化學溶液與PFA管材大面積接觸,因此施工後,為能立即去除附著於內部的汙染物質,進行”前洗淨(**又名flashing)”的作業方式。
然而,為了降低洗淨成本以及時間,管材表面的粗糙度也是改善項目之一。
近來,由於半導體晶片的微型化,影響產量的污染微粒大小已經是奈米級的度量單位。
筆者認為,為探討奈米級顆粒停留在PFA管內表面上的可能性,有必要討論如何測管材的表面粗糙度。本文介紹了以奈米級測量表面粗糙度的方法和需求。
由於管材外部是以定形法(**sizing)押出成形,因此內表面即使不接觸到任何東西也會結晶化。管材外部以水或空氣冷卻,內部採用自然冷卻的方式。此結果為管材內部因球晶而出現龜裂現象。況且,由於有龜裂現象所以表面看起來不平坦。因此認為透過球晶微型化,可改善表面粗糙度。然而,以球晶尺寸為基礎,由粗糙度曲線計算出表面粗糙度,是無法討論奈米級的汙染物質。有必要從基於球晶尺寸的表面粗糙度、到構成球晶層狀晶體(lamella)來討論奈米級的表面粗糙度。
依據球晶尺寸,觀察和球晶邊界之間的不平整,可以了解邊界的表面粗糙度等於球晶表面的不平坦度。
換言之,並非因球晶尺寸導致表面不平整,問題點是球晶表面的不平整。
此外,透過SEM觀察球晶與球晶之間的邊界結果,邊界處沒有凹槽,邊界部分具有與球晶表面相同的表面結果,呈現如圖1。
図1 PFAチューブ内面と球晶境界部のSEM観察
高純度化學溶液與PFA管材大面積接觸,因此施工後,為能立即去除附著於內部的汙染物質,進行”前洗淨(**又名flashing)”的作業方式。
然而,為了降低洗淨成本以及時間,管材表面的粗糙度也是改善項目之一。
近來,由於半導體晶片的微型化,影響產量的污染微粒大小已經是奈米級的度量單位。
筆者認為,為探討奈米級顆粒停留在PFA管內表面上的可能性,有必要討論如何測管材的表面粗糙度。本文介紹了以奈米級測量表面粗糙度的方法和需求。
由於管材外部是以定形法(**sizing)押出成形,因此內表面即使不接觸到任何東西也會結晶化。管材外部以水或空氣冷卻,內部採用自然冷卻的方式。此結果為管材內部因球晶而出現龜裂現象。況且,由於有龜裂現象所以表面看起來不平坦。因此認為透過球晶微型化,可改善表面粗糙度。然而,以球晶尺寸為基礎,由粗糙度曲線計算出表面粗糙度,是無法討論奈米級的汙染物質。有必要從基於球晶尺寸的表面粗糙度、到構成球晶層狀晶體(lamella)來討論奈米級的表面粗糙度。
依據球晶尺寸,觀察和球晶邊界之間的不平整,可以了解邊界的表面粗糙度等於球晶表面的不平坦度。
換言之,並非因球晶尺寸導致表面不平整,問題點是球晶表面的不平整。
此外,透過SEM觀察球晶與球晶之間的邊界結果,邊界處沒有凹槽,邊界部分具有與球晶表面相同的表面結果,呈現如圖1。
図1 PFAチューブ内面と球晶境界部のSEM観察
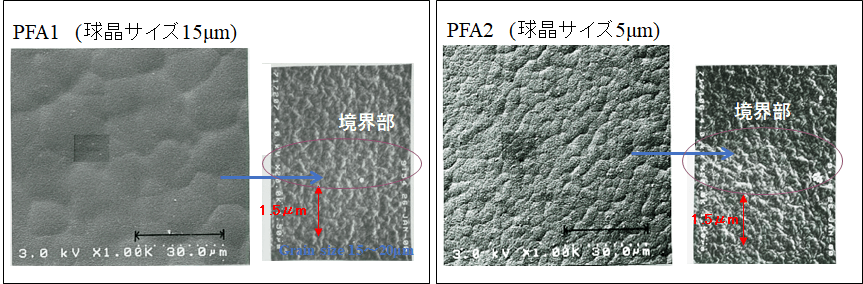
コメント:境界部に溝はなく、球晶表面と同等の表面状態が認められる。
〇氟樹脂材料
- 原料特性
使用由日本氟樹脂工會所編輯「氟樹脂手冊」中所記載3)的市販品PFA,評估管材的表面粗糙度。管材使用30mmφ的圓筒內徑之押出機,採行外部定型法(**sizing)作業成型。通過水冷進行冷卻。 成型溫度條件列於表1。
表1 PFAチューブを評価した原料物性
表1 PFAチューブを評価した原料物性
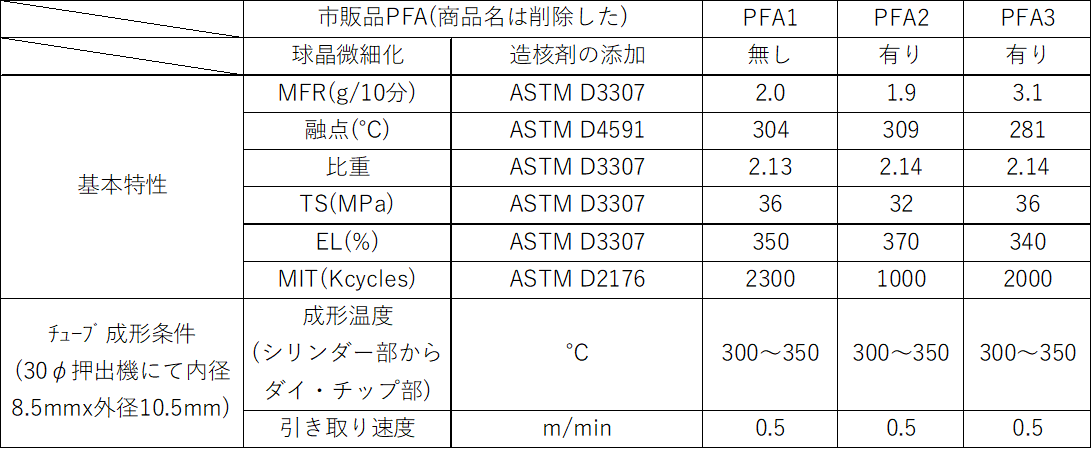
- PFA管內表面的SEM觀察
球晶尺寸為約15μm(15000 nm)的PFA1、市售品中球晶尺寸為約5μm的微型化PFA2,以SEM進行觀察。
〇表面粗糙度的量測方法
(1)現行方法
以球晶形成龜裂的不平整之PFA管材裏面的表面粗糙度作為對象,評估長度400至4000μm之間的範圍進行測量。此表面粗糙度的量測方式為半導體組件的SEMI標準(F57-0301)、JIS標準(B0601)、ISO標準(4287)中所描述的方法。各管材的成型廠商的目錄的數值也以同等的方式進行測量。表面粗糙度Ra之定義如下。算數平均粗糙度是指「從粗糙度曲線,沿著平均線的方向,以基準長度ℓ提取的值,從此提取的部分平均線到測量曲線的偏差絕對值求合計以及平均值」。計算式如圖二。

透由平均化、單個缺陷對測量值的影響很小,可得到穩定的結果。一般多使用觸針式表面粗糙度量測儀,或是非接觸雷射式的方式進行各種加工品的表面粗糙度的量測。 SEMI標準(F57-0301)是半導體PFA材料的代表標準,該標準指出PFA管材裏表面的表面粗糙度為Ra≤0.25μm(250 nm)。為測量PFA管材的裏表面粗糙度,將管材裁斷,長方以觸針式表面粗糙度測量儀進行測量。此時,根據規定表面粗糙度的測定方法的JIS標準(B0601)和ISO標準(4287),以表面粗糙度Ra的大小規定粗糙度曲線的評價長度。詳細解說紀載於日本精密工會雜誌的參考文獻(4)。在標準中,評估長度由表面粗糙度Ra(μm)設定。若0.1 <Ra≤2,則評估長度為4 mm。若0.02 <Ra≤0.1,則評估長度為1.25mm。此外,若Ra≤0.02,則評估長度為0.4mm。若評價長度為0.4至4mm,即400至4000μm,且球晶尺寸為4至50μm,表面粗糙度Ra取決於球晶尺寸的不均勻度。也就是說,球晶尺寸越小,表面粗糙度Ra越小。換言之,PFA管材裏面的表面粗糙度是依據測量球晶形成的龜裂圖案的不平整狀態而得。如圖1所示,即使球晶尺寸為5μm,或大於15μm,球晶與球晶之間的邊界也是平滑的並且不會形成深槽。
以同樣的條件使用原子力顯微鏡(AFM: Atomic Force Microscopy)觀測的話,需要注意縱向倍率會比較大。如以下圖4所示,3 0 μm角的AFM近红外光譜儀照像圖顯示的球晶圖像看起來就只像碗。因此表面粗糙度實際的狀態有可能造成完全不同的成像。球晶與球晶的邊界、球晶表面的表面粗糙度可代表的部分透過圖1的SEM觀察清楚地顯示出球晶邊界。
(2)PFA管橫斷面的TEM觀察
將1吋管的「超微細橫斷面觀察」製成凍結超薄切片法的測試料,使用穿透式電子顯微鏡(TEM)觀察。PFA3的觀察實例以圖3表示。此橫斷面TEM圖像顯示出管內表面有幾奈米到數十奈米的細微凹凸狀。
〇表面粗糙度的量測方法
(1)現行方法
以球晶形成龜裂的不平整之PFA管材裏面的表面粗糙度作為對象,評估長度400至4000μm之間的範圍進行測量。此表面粗糙度的量測方式為半導體組件的SEMI標準(F57-0301)、JIS標準(B0601)、ISO標準(4287)中所描述的方法。各管材的成型廠商的目錄的數值也以同等的方式進行測量。表面粗糙度Ra之定義如下。算數平均粗糙度是指「從粗糙度曲線,沿著平均線的方向,以基準長度ℓ提取的值,從此提取的部分平均線到測量曲線的偏差絕對值求合計以及平均值」。計算式如圖二。

透由平均化、單個缺陷對測量值的影響很小,可得到穩定的結果。一般多使用觸針式表面粗糙度量測儀,或是非接觸雷射式的方式進行各種加工品的表面粗糙度的量測。 SEMI標準(F57-0301)是半導體PFA材料的代表標準,該標準指出PFA管材裏表面的表面粗糙度為Ra≤0.25μm(250 nm)。為測量PFA管材的裏表面粗糙度,將管材裁斷,長方以觸針式表面粗糙度測量儀進行測量。此時,根據規定表面粗糙度的測定方法的JIS標準(B0601)和ISO標準(4287),以表面粗糙度Ra的大小規定粗糙度曲線的評價長度。詳細解說紀載於日本精密工會雜誌的參考文獻(4)。在標準中,評估長度由表面粗糙度Ra(μm)設定。若0.1 <Ra≤2,則評估長度為4 mm。若0.02 <Ra≤0.1,則評估長度為1.25mm。此外,若Ra≤0.02,則評估長度為0.4mm。若評價長度為0.4至4mm,即400至4000μm,且球晶尺寸為4至50μm,表面粗糙度Ra取決於球晶尺寸的不均勻度。也就是說,球晶尺寸越小,表面粗糙度Ra越小。換言之,PFA管材裏面的表面粗糙度是依據測量球晶形成的龜裂圖案的不平整狀態而得。如圖1所示,即使球晶尺寸為5μm,或大於15μm,球晶與球晶之間的邊界也是平滑的並且不會形成深槽。
以同樣的條件使用原子力顯微鏡(AFM: Atomic Force Microscopy)觀測的話,需要注意縱向倍率會比較大。如以下圖4所示,3 0 μm角的AFM近红外光譜儀照像圖顯示的球晶圖像看起來就只像碗。因此表面粗糙度實際的狀態有可能造成完全不同的成像。球晶與球晶的邊界、球晶表面的表面粗糙度可代表的部分透過圖1的SEM觀察清楚地顯示出球晶邊界。
(2)PFA管橫斷面的TEM觀察
將1吋管的「超微細橫斷面觀察」製成凍結超薄切片法的測試料,使用穿透式電子顯微鏡(TEM)觀察。PFA3的觀察實例以圖3表示。此橫斷面TEM圖像顯示出管內表面有幾奈米到數十奈米的細微凹凸狀。
図3 PFAチューブ断面の凍結超薄切片法TEM
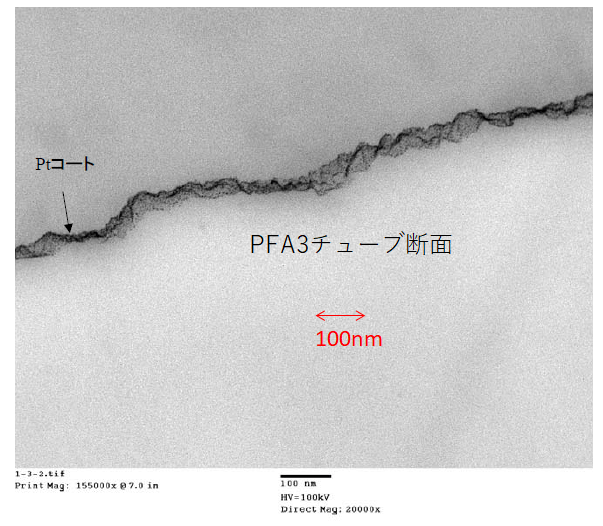
(3) 透過原子力顯微鏡(AFM)測量
關於奈米尺寸的污染微粒子,必須要將球晶表面的奈米尺寸之表面粗糙度視為問題。透過AFM依照以下條件測量了PFA管表面粗糙度,以及將本次測試長度調整為比球晶尺寸小的3μm角領域後的表面粗糙度。透過原子力顯微鏡(AFM)測量的表面粗糙度Ra乃使用掃描探針顯微鏡(AFM5200S(HITACHI High-Tech社製),以Dynamic Force Mode、測試料表面的測量面積3μm角、掃描速度1Hz,x-y方向256×256分割、懸臂SI-DF-20(Si, f=134kHz,C=16N/m)的條件下測出的AFM近红外光譜儀照像圖,是透過傾斜自動校正處理算出的。將AFM觀察的領域設定為3μm角,粗糙曲線的橫軸為29882nm,縱軸為250nm所顯示結果為圖4。其次,將AFM觀察的領域設定為3μm角,粗糙曲線的橫軸為2988nm,縱軸為39nmn其顯示結果為圖5。圖4突起部分的波型表示為一個球晶。縱橫向的比例與實際不同,圖4的縱向倍率約放大了20倍,因此成像看起來比實際的凹凸誇張明顯。另一方面,如文獻(2)記載的射出成型品會大大受模具表面的表面粗糙度影響(依存?),與模具的接觸面不會出現球晶造成的六角型。另外,因機械加工所切削的表面也不會出現球晶表面。這些種種比壓出成型的管內面之表面粗糙度還粗,SEMI規格(F57-0301)所記載的,相較於PFA內側表面的表面粗糙度Ra≦0.25μm,射出成型品是Ra≦0.38μm、機械加工品則是Ra≦0.62μm。這些情況下也有因為傷痕的影響導致表面粗糙度變大的狀況。但是管狀的話,如同前述記載,可了解並非依照球晶尺寸來測量表面粗糙度,而必須要測量球晶表面的粗糙度。
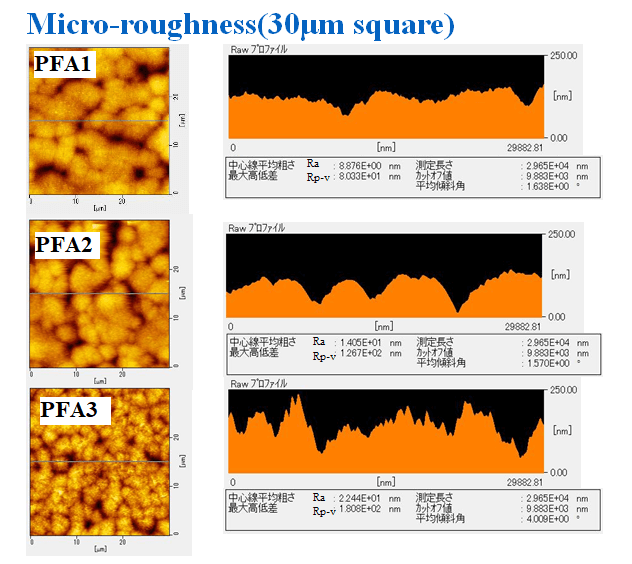
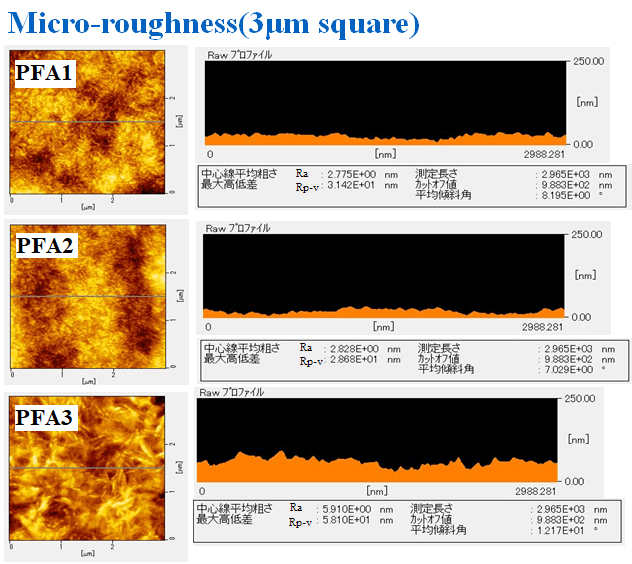
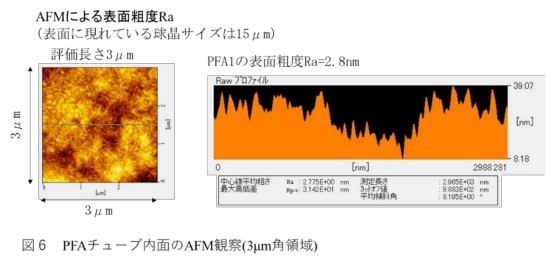
(4)PFA材料與各種表面粗糙度測定方法之比較
將PFA1,PFA2,PFA3的原料成型的PFA管,來比較AFM測定的球晶表面的表面粗糙度Ra。將其測定結果以圖4、圖5、圖6來表示。各種測定領域,換句話說就是改變測量長度來測量表面粗糙度,將其結果整理成表2。
表2 PFAチューブの表面粗度測定結果のまとめ

測量長度為3μm的情況下,得到PFA1,PFA2 Ra=2.8(nm)的結果。
PFA3的結果為Ra=5.9(nm)。
注) 表(1)中的Ra為,從粗糙度曲線上去除基準長度的部分,並將該部分的平均線到測量曲線的偏差絕對值,相加後平均出來的值,就是表面粗度(表面粗糙度)。
(2) Rp-v(在記載上也有被稱為Ry)是從粗糙度曲線上去除基準長度的部分,並將該部分的平均線到最高峰Yp和到最谷底Yv的總和,即為Rp-v = Yp + Yv。
在傳統的表面粗度中,球晶的邊界存在著凹槽,可以想像的出,那個凹凸的大小被大小為20~60nm的異物附著在上面的樣子。但是,實際按比例繪製圖形時,可以發現如圖7所示,與實際的情況有很大的差距。
図7 球晶サイズ基準と球晶表面の表面粗度
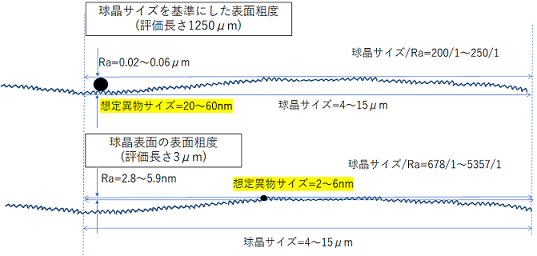
這次所提案的球晶表面的表面粗度,異物尺寸為2~6nm。可以輕易的想像出,它附著在凹凸上合適的樣子。是符合實際情況的測試方式。
(5)奈米尺寸的表面粗度分析
形成在球晶表面上的凹凸,是由該分子鏈的折疊結構,許多束的層狀晶體所組成的層狀晶束所形成。奈米尺寸凹凸(平滑性)的大小,是由層狀晶束的大小所決定。 PFA是TFE和PAVE的共聚物,但是根據PAVE的類型和成核劑的數量,層狀晶束的大小可能會有所不同,奈米的光滑度也會出現差異。如下圖8所示,球晶表面的SEM觀察,是用エリオにクス社所製造的ERA-9000在進行。
図8 PFAチューブの球晶表面のSEM(3万倍)観察
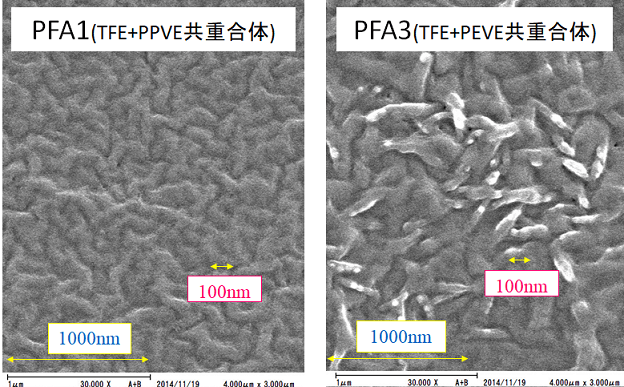

結果如圖8所示,算數平均粗度的Ra是平均值。但在同一裝置,電線三次元粗糙度分析上,長度1μm中的測試中,測量了其深度和數量的結果如圖9所示。透過這次的提案,由3μm角上的AFM來測量球晶表面的表面粗度的方式。
說不定在在下個半導體芯片的時代中,被視為問題的微粒子異物問題能透過表面粗度來對應,將被熱烈討論一番呢。
最後
隨著球晶的微細化,很明顯的關於目前平滑度的討論與實際情況的是相差甚遠的。
透過SEM的觀測上可以很明顯的得知,在球晶邊界上沒有深的溝槽,而是與球晶表面的表面結構是相同的。 換句話說,奈米等級上球晶表面的表面粗度所指的是,管材內全體表面的表面粗度。
在本文中,我們以PFA管材的表面粗度作為測量,透過AFM來測量球晶表面的表面粗度的方式,來對應半導體芯片的微細化。 但是,即使是最新的粒子測量器,也僅限於測量在尺寸20~30 nm之間。
期待未來在奈米表面粗度以及奈米粒子的污染和清潔關係上,能有進一步的探討。
